来源 :内容来自fractilia。变异性是半导体制造业的敌人。芯片内部、晶圆之间以及晶圆之间的结构变革会降低芯片的性能、产量和靠得住 性。汗青上,这些变异性是“全局性的”,由晶圆平整度或热板匀称性等因素引起的系
|
来源 :内容来自fractilia。 变异性是半导体制造业的敌人。芯片内部、晶圆之间以及晶圆之间的结构变革会降低芯片的性能、产量和靠得住 性。汗青上,这些变异性是“全局性的”,由晶圆平整度或热板匀称性等因素引起的系统性工艺偏差发生在毫米级的长度尺度上。晶圆边沿邻近 的低产量就是常见的结果之一。 然而,跟着 最新节点半导体器件特性尺寸的不停缩小,一种新型的变异性——随机性——已经出现,并对器件的产量、靠得住 性和性能发生 了负面影响。随机性是图案化进程 中固有的随机变异,当尺寸靠近原子级别时就会出现。与全局变异性差别,随机性影响“局部”层面,其中彼此 靠近的图案化特性在尺寸上大概存在显著差别,这会影响产量并导致器件性能的波动。 在前几代器件中,随机变异性并未显著影响器件产量或性能。但在最新一代节点中,这种局部随机变异现在大概占某些范例制造偏差的50%以上,这些偏差直接影响器件。现在,不受把握 的随机变异每年大概使制造商在每个晶圆厂丧失数亿美元,这表现在产量丧失和临蓐 爬坡耽误上。这些曾经可以忽略不计的变异,现在决定了2纳米及以上先辈节点的可行性。 随机性作为晶圆厂EPE偏差预算的百分比:  随机性是一个日益严肃的良率问题,在EUV(极紫外光刻)技巧 中,它大概占总图形偏差预算的50%以上。 因此,现在器件制造商优化和把握 随机性至关求助 ,而这需要一套差别的对象 ,这些对象 偏重于随机性的概率性质 。 随机效应的范例 在半导体制造中,存在四种范例的随机效应: 线边沿粗糙度或线宽粗糙度(LER/LWR):晶体管或其他症结 特性的边沿不服 滑 。这会影响栅极漏电流、导线电阻、芯片功耗和靠得住 性。 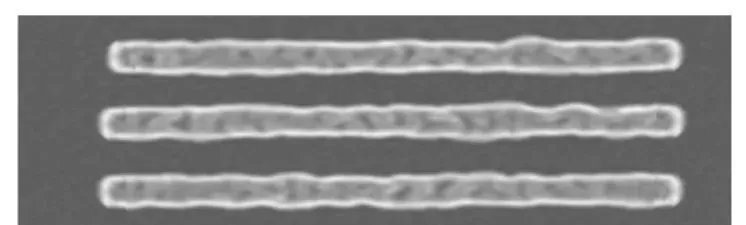 图1 线边沿粗糙度造成局部症结 尺寸变异 局部症结 尺寸匀称性(LCDU):相邻器件的症结 尺寸差别。这会影响良率和芯片速度 。 局部边沿地位 偏差(EPE):边沿随机定位,大概导致短路或开路。这会影响良率和靠得住 性。  图2 边沿地位 偏差 随机缺点 :芯片特性出现线路桥接或断裂、接触孔缺失或合并等环境。这些缺点 会影响良率和靠得住 性。  图3 接触孔缺失 随机效应为何日益严肃? 为相识释随机性在最新工艺节点中为何日益严肃,让我们以光刻工艺为例。在半导体光刻工艺中,扫描仪使用光线在光刻胶上曝光图案,然后蚀刻失踪 不需要的部分以创立 特定尺寸的特性。 在器件特性相对较年夜 的老一代节点中,可以假定所有相邻特性的尺寸都雷同。这是由于工艺的随机变异性(以及局部变异性)相对较小。比方,100纳米特性尺寸的随机变异性平日 仅为特性尺寸的2%到3%。 对于较年夜 的特性尺寸来说,这种微小的影响使得器件制造商在很年夜 水平上可以忽略制造进程 中的随机变异性,并仍然成功地将其制造产能提拔至高良率。为了实现这一成功,器件制造商不停依赖于猜测性工艺模子、输出平均测量值的测量对象 以及将光刻、抗蚀剂和蚀刻工艺视为同等实体的筹划规则。这种方法 被称为确定性建模,半导体行业几十年来不停成功地采用这种方法 。 然而,行业现在已经改变了。 在线边沿粗糙度(LER)达到2纳米时,环境变得尤为复杂。 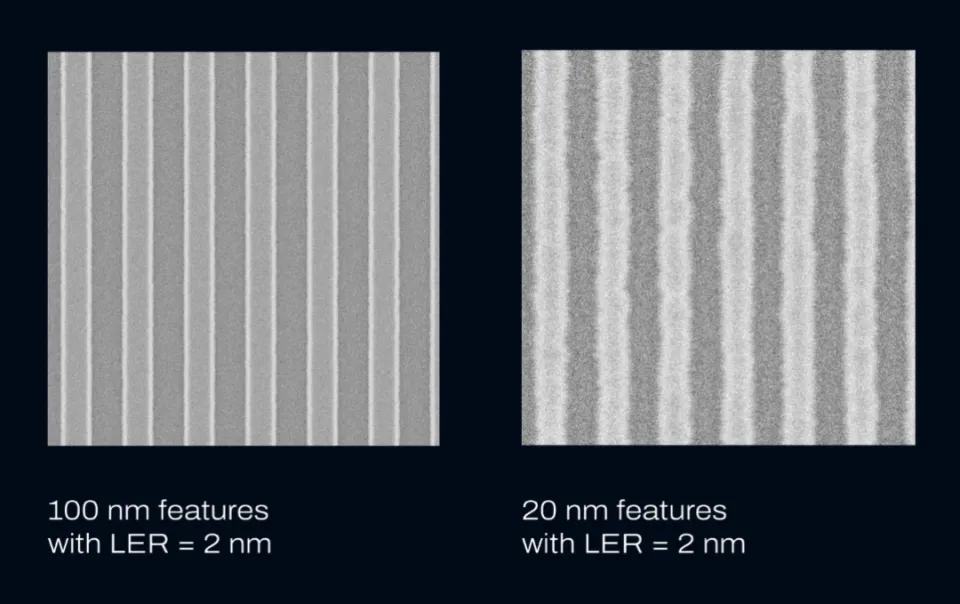 2 纳米线边沿粗糙度下的特性 光子散粒噪声与随机效应的加剧 现在,很多器件制造商使用 EUV 扫描仪来制造其器件中最小的特性。在其他条件雷同的环境下,EUV 扫描仪曝光雷同体积光刻胶的光子数目是193纳米扫描仪的十四分之一。对于 EUV 工艺,相邻的两个特性大概被数目差别显著的光子曝光,这种征象称为光子散粒噪声。这导致相邻特性的尺寸差别,这种效应经由进程 局部症结 尺寸匀称性(LCDU)来权衡。 为了补充这种影响,我们可以增长 EUV 对象 的剂量,这将增长每单元面积的光子数目并淘汰 随机变异性。但增长扫描仪剂量会直接降低 EUV 扫描仪的吞吐量,从而增长成本。因此,工程师需要权衡利弊,确定符合的调和 方案。 跟着 器件特性尺寸缩小到分子和原子级别,随机变异的相对巨细现在已达到特性尺寸的10%或更多,并占图案化进程 中总变异性的一半以上。而且 ,随机性不仅仅是 EUV 工艺特有的征象——当使用193nm浸没式扫描仪摆设多重图案化技巧 时,随机变异性也是总偏差率的求助 影响因素。 在最新一代节点中,不能再假定相邻印刷特性的尺寸雷同——现在需要准确优化和把握 随机性。 下图比力了在恒定曝光剂量和光刻胶吸收系数下,193纳米光(左)与13.5纳米(EUV)光(右)在给定体积内吸收的光子数目。  光子散粒噪声 对差别测量和剖析 方法 的需求 随机变异性现在是包括掩模印刷、光刻、刻蚀和沉积在内的众多 制造步骤 中一个症结 的偏差来源 。要优化和把握 这些工艺,首先需要能够 准确细密地测量随机效应。究竟,无法测量就无法把握 。 求助 的是,准确测量随机性极其艰苦 ,由于测量对象 自己(如CD-SEM)大概引入与所测量效应一样年夜 的测量偏差。因此,行业需要专门的测量和剖析 技巧 ,能够 去除SEM噪声,从而准确报告随机偏差。然而,传统的测量方法 和对象 在测量和去除这种测量噪声方面表现不够 理想。 别的,为了正确剖析 随机性,必须采用概率方法 ,这与行业汗青上使用简直定性方法 年夜 相径庭。仅仅使用平均测量值无法对随机性的影响做出准确的判断。 比方,概率建模需要准确的偏差棒来确定事件发生的概率。为此,所有随机性测量都需要包罗形貌测量不确定性的准确偏差棒。但是,确定随机性的准确偏差棒需要与行业中常用的统计对象 差别的对象 。 当工程师和主动化把握 系统能够 获得准确的随机性测量数据时,他们可以在开发阶段为每一层做出明智的决策,在爬坡阶段更快地淘汰 变异性,并在临蓐 中把握 工艺。别的,随机偏差直接影响芯片筹划的优化和OPC(光学邻近 校订 )的应用。因此,现在需要除了随机性感知工艺把握 之外,还使用随机性感知OPC建模。 半导体行业传统的剖析 对象 不停专注于确定性建模,但为了准确优化和把握 随机性,行业需要一套差别的测量和剖析 对象 。 总结 半导体制造中最新一代的节点存在显著的随机变异性,称为随机性,需要对其进行优化和把握 。这个问题跟着 每一代新技巧 的出现而变得愈发严肃。 随机性迫使晶圆厂在良率和临蓐 力之间做出权衡。比方,经由进程 增长EUV光刻扫描仪的剂量,晶圆厂可以淘汰 随机性的影响并提高 良率。但这也伴跟着 巨年夜 的成本:工艺对象 吞吐量的显著降低。当晶圆厂准确把握 随机性时,他们可以同时提高 工艺对象 的临蓐 力并增长良率。 把握 随机性的第一步是使用准确细密的测量技巧 。你无法把握 你无法测量的事物。 参考链接 https://www.fractilia.com/intro-to-stochastics *免责声明:本文由作者原创。文章内容系作者小我 概念 ,半导体行业观察 转载仅为了传达 一种差别的概念 ,不代表半导体行业观察 对该概念 赞同或支持 ,如果有任何异议,欢迎联系半导体行业观察 。 |
2025-05-03
2025-03-05
2025-02-26
2025-03-05
2025-02-26