本文由半导体财产纵横(ID:ICVIEWS)综合该系统制冷系数(COP)最高可达10万,显着优于传统冷却技术。克日,东京年夜 学的研讨 团队颁布 了一种创新的3D水冷系统,该系统充分使用了水的相变过程,实现了高达7倍的热通
 本文由半导体财产纵横(ID:ICVIEWS)综合 该系统制冷系数(COP)最高可达10万,显着优于传统冷却技术。  克日,东京年夜 学的研讨 团队颁布 了一种创新的3D水冷系统,该系统充分使用了水的相变过程,实现了高达7倍的热通报屈从 提拔。这一研讨 结果现在颁发 在《Cell Reports Physical Science》杂志上。 摩尔定律所形貌的芯片连续微型化趋向 不绝是数字期间成长 的强年夜 动力。然而,跟着 芯片尺寸不断缩小且机能 日益强年夜 ,散热问题渐渐成为制约其成长 的症结 瓶颈,现有的冷却技术已难以满意需求。 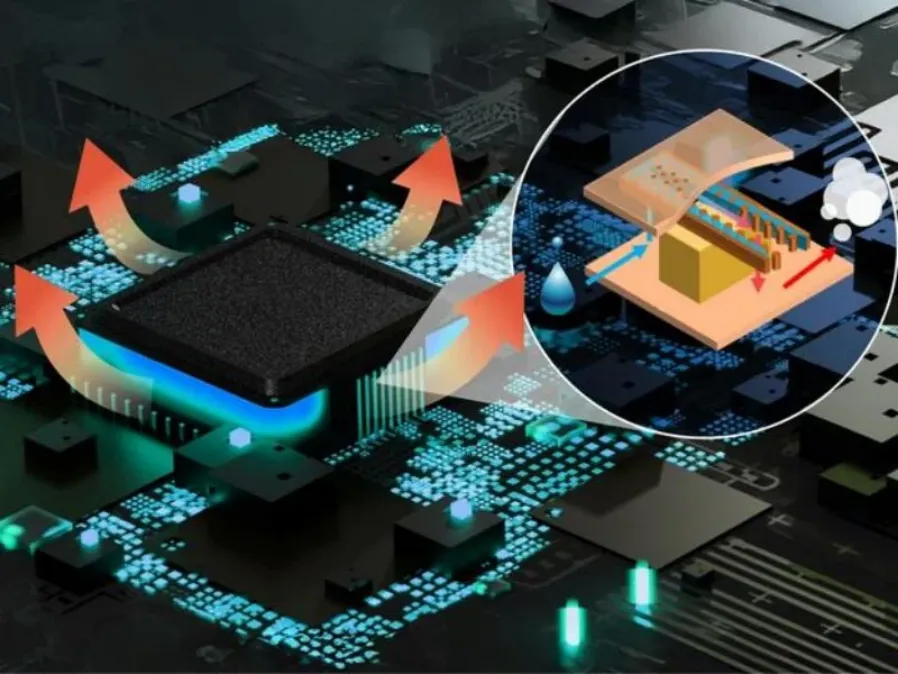 现在,一种有效的冷却办法 是在芯片内部直接构建微通道。这些渺小 的通道通过轮回 水汲取并带走热量。然而,这种办法 受到水的“显热”的限制,即水在不发生 相变的情况下能够汲取的热量。相比之下,水在沸腾或蒸发时汲取的“潜热”年夜 约是其显热的 7 倍。该研讨 的重要作者解释称:“通过使用水的潜热,可以实现两相冷却,从而显着进步散热屈从 。” 此前的研讨 已经展现 了两相冷却的潜力,但也指出了该技术的复杂性,重要是由于在加热后难以把握 蒸汽气泡的活动。同时进步热通报屈从 取决于多种因素 ,包含 微通道的几何形状、两相流的调控以及活动阻力。 此次研讨 的新型水冷系统包含 三维微流体通道布局,使用毛细管布局和歧管分派 层,同时设计和制作 了各种毛细血管几何形状,并在一系列条件下研讨 了它们的特性。 其焦点技术采用双级活动设计:冷却剂先流经宽幅歧管,再进入20微米宽的精密微通道收集 ,精准锁定芯片热门实现刹时汽化散热。团队证明该筹划 热流密度可达1千瓦/平方厘米,完美适配下一代AI芯片需求,且微通道可直接蚀刻于硅晶圆背面 ,兼容现有半导体工艺。 研讨 发现,冷却液流经的微通道的几何形状以及把握 冷却液分派 的歧管通道,都邑 影响系统的热机能 和水力机能 。按照 其所测量的有效冷却输出与所需能量输入的比率,即制冷系数(COP),最高可达10万,这一数字显着优于传统冷却技术。 当前的芯片散热筹划跟着 芯片技术的不断进步 ,芯片机能 在日益提拔的同时功耗也随之增长。按照 统计数据,电子元器件温度每升高2℃,可靠 性下降 10%,温度达到50℃时的寿命只有25℃时的1/6,是以 数据中心及AI芯片厂商都在不断探索散热技术以保证其产物机能 。 前文提到的芯片内微通道散热就是当前芯片散热的一种技术。该技术最初是由斯坦福年夜 学的TUCKERMAN和PEASE在1981年提出,其在硅衬底上加工了宽度为 50 μm的微通道布局,在 790 W/c㎡的热流密度下,芯片的温升被把握 在71℃以内。2022 年,北京年夜 学提出了一种双H型芯片歧管内嵌冷却布局,采用硅-硅键合工艺集成,可针对面积为400m㎡、功耗为417W的芯片,在温升为22.2℃的情况下,实现了对104.3 W/c㎡热流密度的冷却。另外,洛桑联邦理工学院的研讨 人员再次升级 了嵌入式冷却的想法,从一开端 就将电子元件和冷却装置设计在一起 ,在芯片内部设计了三维冷却通道,在晶体管的有源部门下方,隔断现实发生 热量的处所 只有几微米,如许可以防止热量在整个设备中扩散。 跟着 市场需求的增长 ,越来越多的企业开端 涉足芯片级散热领域,芯片厂商台积电、英伟达、英特尔等均有本身的散热筹划 。 其中 ,台积电在2021年针对高机能 芯片提出了两种近芯片冷却筹划 ,一种是在芯片与硅微通道之间采用氧硅键合举办 集成,可在特定温升和功耗下实现有效冷却;另一种是片上水冷技术,能满意差别参数芯片的散热需求。2022年又提出浸没式两相冷却筹划 ,将浸没式冷却应用 于高功率封装上,热阻低,可在一定温升下实现高功率密度的冷却,且该筹划 在电源使用屈从 方面表现优异,有望成为将来数据中心或超算中心主流的冷却办法 之一。 英伟达推出了基于直接芯片冷却技术的A100 800G PCIe液冷GPU,较风冷版本机能 相当,但电力节流30%左右,单插槽设计节流最多66%的机排挤间。2024年颁布 的GB200 NVL72,单功率约120kw,采用液冷系统设计,低落了成本和能耗。别的,英伟达还率先采用钻石散热GPU举办 测试实验,机能 显着提拔。 英特尔的散热筹划 重要是通过“新质料和布局改革 ”,涵盖了从3D均热板的改良 和射流液体冷却,以及浸没式冷却相干的优化设计。比方筹划通过改良 的沸腾涂层来促进两相冷却中的成核点密度,进步均热板工质的核沸腾能力,并低落干戈 热阻。 日月光半导体在2024年10月颁布 的“封装布局”专利中,引入了一种第一热电布局,具备温度感测模式和制冷模式。该热电布局能够穿入介电层,切近 芯片的第一外貌,从而在制冷模式下对芯片供给 有效的冷却。 值得注意的是,按照 相干数据表现,2024年举世数据中心热办理 市场范围 为165.6亿美元,估计 到2029年将增长 至345.1亿美元,2024-2029年的复合年增长 率(CAGR)为15.8%。从技术渗出率来看,Omdia估计 2023年数据中心风冷和液冷市场范围 为76.7亿美元,其中 液冷的渗出率约为17%。 *声明:本文系原作者创作。文章内容系其小我 不雅 点,我方转载仅为分享与讨论,不代表我方同意或认同,若有 异议,请联系 背景。 |
2025-05-03
2025-03-05
2025-02-26
2025-03-05
2025-02-26