固然近期台积电高管表现,台积电接下来的A16/A14制程都不会接纳ASML售价高达4亿美元的High NA EUV光刻机(具有0.5数值孔径),但是英特尔则已经决议 在其下一代的Intel 14A制程上选择接纳High NA EUV光刻机举行量产。
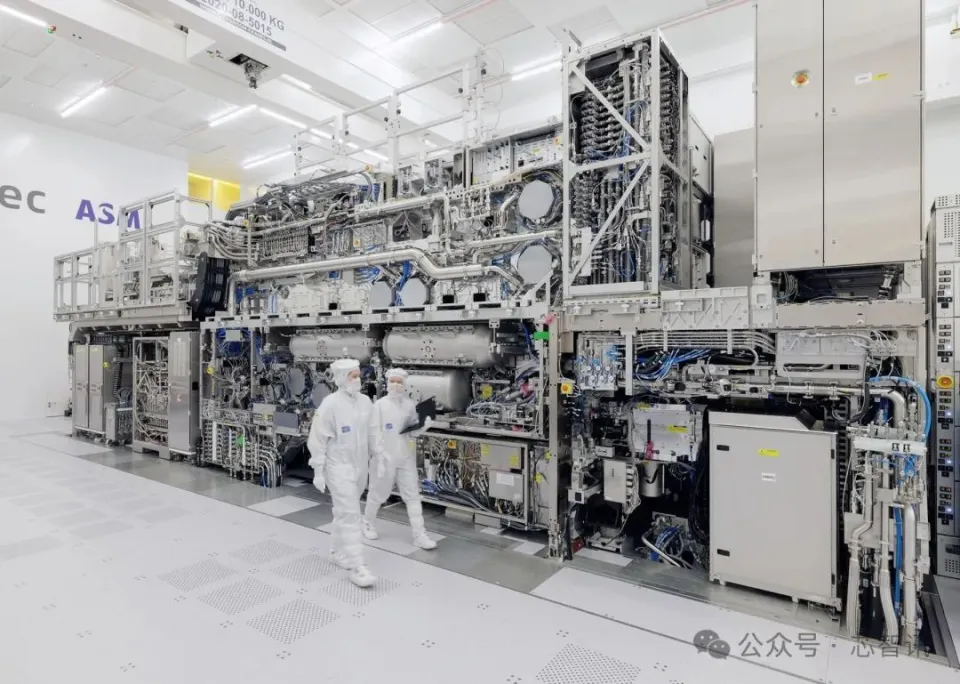 固然近期台积电高管表现,台积电接下来的A16/A14制程都不会接纳ASML售价高达4亿美元的High NA EUV光刻机(具有0.5数值孔径),但是英特尔则已经决议 在其下一代的Intel 14A制程上选择接纳High NA EUV光刻机举行量产。 与此同时,为了解决未来的1nm以下制程的制作 问题,ASML正在积极的研发具有0.75NA的Hyper NA EUV光刻机,这也意味着其将面对更大年夜 的技术寻衅,要知道ASML花了约20年的时光 才乐成鞭策 标准型EUV光刻机的规模 商用。 而作为急需在EUV光刻机上举行冲破 的中国,则将目光瞄向了基于直线电子加速器的自由电子激光技术的EUV光源(EUV-FEL)技术。 EUV光刻机:17年的时光 和90亿美元的研发投入 现在全球几乎所有的7nm以下的制程工艺都周全 接纳了ASML的EUV光刻机来举行量产,同时随着DRAM制程进入到10nm,美光、三星、SK海力士等存储大年夜 厂也开始或筹划导入EUV光刻机。 固然上一代的193nm浸没式光刻机接纳多重曝光技术将制程工艺推进到7nm摆布 (极限乃至可以到5nm,但是良率会大年夜 幅降低),但是使用多重曝光会带来两大年夜 新问题:一是光刻加掩膜的成本上升,并且 影响良率,多一次工艺步骤 就是多一次良率的降低;二是工艺的循环 周期延长 ,因为多重曝光不但增长曝光次数,并且 增长刻蚀(ETCH)和机器研磨(CMP)工艺次数等,这也会带来成本的大年夜 幅上升和良率的降低。 而要解决193nm浸没式光刻所面对的问题,最为有效的办法 就是经由过程 进一步缩短光源波长来提升光刻分辨 率。是以 ,在20多年前,头部的晶圆制作 商和ASML就将目光瞄向了光源波长只有13.5nm的EUV(极紫外光)光刻技术。 1997年,英特尔牵头开办了EUV LLC同盟,随后ASML作为独一 的光刻设备 临盆 商到场同盟,共享研讨 成果。随后,ASML经由过程 一系列的收购(好比收购美国准分子光源供给 商Cymer等)和自身的研发,在2010年初次推出了概念性的EUV光刻系统 NXW:3100,但是直到2016年面向量产制作 的EUV系统 NXE:3400B才开始批量发售,从真正开启EUV光刻系统 的新期间。 据ASML此前介绍 ,对于EUV光刻机的研发,ASML总计花了90亿美元的研发投入和17年的研讨 ,才最终获得了乐成,最终到进入大年夜 规模 商用更是花了约20年的时光 。 相对于193nm浸没式光刻机,EUV光刻机不仅可以使得光刻的分辨 率大年夜 幅提升,同时一次就能曝出最小距离为 13nm 精细图形,并且 也不须要浸没系统 ,没有超纯水和晶圆接触,在产品临盆 周期、OPC的庞杂 水平、工艺控制、良率等方面的优势明显。固然,独一 的劣势在于最初的价格高达1.5亿美元一台。 依附着英特尔、台积电、三星着三大年夜 头部先辈制程客户的强力支持 ,再加上ASML自身在EUV光刻范畴的一连研发投入,以及在EUV光刻设备 上游的关键器件和技术范畴的多笔收购及投资布局,使得ASML多年来不绝是全球EUV光刻机市场的独一 供给 商。 领导 ASML 研讨 部分的 Jos Benschop 说:“几十年来,在摩尔定律的鞭策 下,过去每一代新的制程节点的晶体管长度和宽度都缩小了 70%。但是现在每一代微缩的幅度已经降低到了大年夜 约20%。”固然现在最先辈的High NA EUV光刻机可以打印 8nm 的线条,距离大年夜 约为 32 个硅原子。但是当晶体管间距靠得如此 近时,量子隧穿效应就可能会涌现 ——电子可能将体现出不可预测的举动。  自 90 年代末以来,不绝从事 EUV 研讨 的 Benschop 说:“按照 最初的缩放比例,我们将在 2065 年摆布 达到四分之一纳米(2.5埃米)的水平,即两个硅原子之间的距离。但是,按照 现在的估计 ,我们可能会鄙人 个世纪中叶才达到那个点。”是以 ,在未来几十年中,ASML 可以继续尽可能高效地缩小晶体管的尺寸。但是怎么做到呢? 携手 ARCNL 据荷兰媒体NRC报道,ASML除了自身投入大年夜 量的资金举行技术研发之外,也有与阿姆斯特丹纳米光刻高级研讨 中央 (ARCNL)举行合作。 据介绍 ,ARCNL 创建于十年前,与阿姆斯特丹大年夜 学的合作搭档关系。鞭策 者是 ASML 的前技术总监兼团结总裁 Martin van den Brink,他已于去年退休。ASML公司付出了 ARCNL 预算的三分之一(每年约 400 万欧元),以便 80 名科学家可以研讨 前沿的光刻技术的构建模块。ARCNL 的使命是改进ASML现有的EUV光刻技术,并在未来 EUV 失踪 败的情况下研讨 替代办法 。 Wim van der Zande 自 2022 年以来不绝担任 ARCNL 的董事,之前曾在 ASML 的研讨 部分工作。学者们与费尔德霍芬和圣地亚哥的 ASML 研讨 职员以及荷兰和国外的技术大年夜 学合作。“这是一个完整的生态系统 ,”Van der Zande 说。 ARCNL 在与 ASML 相关的范畴举行研讨 ,该公司是第一个有机会评估新想法的公司。这种合作让人想起 NatLab。这个前飞利浦实行室做出了 CD 播放器等著名创造 ,也为 ASML 的光刻技术奠定了底子。NatLab 举行了首创 性的研讨 ,即使 它没有直接的商业运用 ,最终被飞利浦减少。 ARCNL 的科学家们意识到 ASML 最紧张的寻衅:经济可行性。毕竟,不为芯片制作 商赢利的呆板是不会有什么买家的。ASML 现在每年在研讨 方面的投资凌驾 40 亿欧元,远高于其他荷兰公司,是以 它可以将 ARCNL 纳入自己的办理 之下。但这种做法将有损于开放的学术研讨 。 Van der Zande表现:“作为一名科学家,你可以花许多年时光 举行一项研讨 ,但商界只关注短期,可能会突然制止一个项目。”只管如此 ,大年夜 约四分之三的 ARCNL 研讨 职员在获得博士学位后继续在 ASML 工作。 更短波长的光源 1984年,当 ASML 创建时,光刻机使用波长为 365 或 436nm 的汞灯作为光源。随后是 248 纳米和 193 纳米的激光。数年前已经跃升至 13.5nm的EUV光源。 现在科学正在探求合适的 6.7nm 和 4.4nm 波长的光源。有一些元件可以为 EUV 反射镜供给 透明度和反射的精确组合——对于 6.7 纳米,这些材料是羊毛甾烷和硼。缺点:在较短的波长下,反射结果较差。 为了产生 6.7 纳米的光,ARCNL 正在构建一个使用钆而不是锡的研讨 装置。然而,较短的波长并不是万能的。能量分布在较少的光子上,如果您想打印纳米级的线条,这会增长堕落的风险。用技术术语来说:会有随机噪声。“总而言之,我以为我们进入更小波长的可能性很小,”Benschop 说。 更大年夜 的数值孔径 光刻机的分辨 率的提升除了可以依靠于缩短光源的波长之外,还可以通提升镜头的数值孔径(NA)的来举行提升。现在的 EUV光刻系统 的数值孔径是 0.33 NA,而ASML最新推出的High NA EUV系统 的数值孔径已经提升到了0.5 NA。 为此,ASML 的合作搭档蔡司(Zeiss)不得不利 用直径凌驾一米的更大年夜 镜子,同时蔡司还必需 开发庞杂 的丈量设备 ,以将物镜的误差降低到低至原子的偏差。 (其实早在2016年11月5日,AMSL就收购了卡尔蔡司半导体系体例 造技术公司(Carl Zeiss SMT)的24.9%股权,以强化双方在半导体微影技术方面的合作,研发High NA EUV光刻系统 。) ASML 及其镜头供给 商蔡司要想鞭策 High NA EUV商用,还必需 团结供给 链做出更多的妥协。 首先,High NA EUV的芯片图案地点的视场较小。是以 ,较大年夜 的芯片设计必需 切成两半,然后再从新 绑在一路 ,这很贫苦。 其次,High NA EUV固然分辨 率更高,但焦深较小。这须要调解光敏涂料,它必需 具有差别的化学成分,并且必需 涂得特殊薄(小于 20 纳米)。 第三,晶圆自己也必需 特殊平展,以防止偏差。 在High NA EUV乐成推出的同时,ASML 和 蔡司还正在研讨 新一代的数值孔径为 0.75 NA 的 Hyper NA EUV光刻系统 。 Jos Benschop表现,Hyper NA EUV光刻系统 的物镜并不一定非得更大年夜 ,“你也可以把最后一面镜子放在离芯片更近的处所 ,这样你就会获得 同样的结果。缺点是更多的光线会反射回来离去 ——这就是镜子的情况。” Hyper NA EUV另有一个长处,更大年夜 的数值孔径可以处置处分 更多的光线,就像你倒空宽颈的瓶子比清空窄颈的瓶子更快。是以 ,Hyper NA EUV不仅能够 打印出更清晰的线条,并且 打印速度也更快。 按照 Martin van den Brink 此前披露的ASML未来15年的逻辑器件的工艺门路图来看,使用现在的0.3NA的标准型EUV光刻机支持 到2025年2nm的量产,再往下就须要经由过程 多重曝光技术来实现,但支持 到2027年量产的1.4nm将会是极限。 而0.55NA的High NA EUV光刻机则可以支持 到2029年1nm制程的量产,如果接纳多重曝光,则可以支持 到2033年量产的5埃米(0.5nm)制程节点。  再往下就可能必须要 接纳0.75NA的Hyper NA EUV光刻机,或许可以支持 到2埃米(0.2nm)以下的制程节点,这里门路图上打了一个问号,以是不肯定 Hyper NA EUV光刻机能 否支持 下去。按照 ASML的规划,Hyper NA EUV光刻机首款产品可能将会在2030年前后推出。 这里须要强调的是,固然一个硅原子的直径大年夜 概就在1埃米摆布 ,但是这里的所有的制程节点定名都只是等效指标,并不是真实的物理指标。2埃米制程节点的对应的晶体管的金属间距为大年夜 约在16-12nm,进入到2埃米以下制程以下,金属间距才会进一步缩小到14-10nm。 以是, Benschop 才会说,估计 到下个世纪中叶,晶体管之间的间距才有可能进一步缩小到 1/4 nm 的水平。 更高的EUV光源功率,更低的能耗 现在ASML的EUV光源(被称为激光等离子体光源),是经由过程 使用德国通快(Trumpf)公司的30千瓦功率的二氧化碳激光器,每秒2次轰击雾化的锡(Sn)金属液滴(锡金属液滴以每秒50000滴的速度从喷嘴内喷出,即每秒须要10万个激光脉冲),将它们蒸发成等离子体,经由过程 高价锡离子能级间的跃迁获得13.5nm波长的EUV光线。然后经由过程 对EUV光举行收集,并经由过程 反射镜修正光的前进方向,最终进入到镜头,感化 到芯片外貌的光刻胶。  △ASML EUV光源的微型版本 由于EUV光线波长非常 短,以是它们会很容易被空气吸取,以是全部 EUV光源的工作环境须要被抽成真空。同时,EUV光线也无法被玻璃透镜折射,必需 经由过程 蔡司的以硅与钼制成的特殊镀膜反射镜,来修正光的前进方向,并且 每一次反射可能将会损失踪 约30%能量,而EUV光学照明系统 当中有6组反射镜,导致最终达到 晶圆外貌光阻层的EUV光源的功率理论上只有原来的约1%摆布 。  按照 材料 显示,在2015年之时,ASML才想法将EUV光源提升到了100W,其巨大年夜 的drive laser(驱动激光器)加上其他部分,使得全部 EUV光刻机的功耗达到了惊人的15000KW。现在,ASML已经将EUV光刻机的EUV光源功率提升到了500W,接下来ASML筹划进一步将功率提升到1000W,同时ASML希望一连降低能耗。ASML 估计 ,到 2033 年,每个照射 晶圆的 EUV 能耗将比 2018 年减少约 80%。 如何来实现这些目的呢?据NRC称,ASML筹划将每秒喷射的50000滴锡金属液滴提升到60,000 个,从而提升产生 的EUV光源的功率。别的,为了更有效地使用来Trumpf 公司的激光器,ASML 希望drive laser使用固体激光器,因为它将消耗更少的能量。ARCNL也曾发起使用固体激光器来降低能耗。 “夹层蛋糕”式反射镜 正如前面所指出的是,现在ASML的EUV光线接纳的是经由过程 蔡司的以硅与钼制成的特殊镀膜反射镜,来修正光的前进方向,每一次反射可能将会损失踪 约30%能量,这也意味着如果颠末10面反射镜,可能只剩下不敷3%的本事。而ASML的High NA EUV如果接纳了相对较少的反射镜,那么可以感化 于晶圆外貌光刻胶的EUV光源功率更高。但是,如果反射镜更少,可能就很难纠正 镜头误差。 NRC称,特温间谍 业大年夜 学的研讨 职员正在研发新的镜面涂层,该涂层由一堆瓜代的钼和硅层组成 ,一种材料是可以反射EUV光线的,另一种则是透明的,统共丰年 夜 约 70 个“多层”相互重叠,每个层的占比略低于 3%。 “例如,我们现在实现了高达 71% 的反射率,靠近理论上可以达到的 75%,”Marcelo Ackermann 教授说。他领导 XUV Optics 小组,与蔡司和ASML合作研讨 涂层配方。该实行室创建在 Fred Bijkerk 教授于 1990 年代初在 Nieuwegein 的 FOM 研讨 所开始的 EUV 研讨 的底子上。 盘算好像很简朴:反射层的厚度必需 达到波长的一半。诀窍在于正确的构图和仅 10nm厚的每一层的整洁分层。这是经由过程 一种 Ackermann 称为“微波溅射”的办法 完成的。与最早的 EUV 反射镜相比,这种“夹层蛋糕”式的反射镜的各层现在彼此之间加倍 精密地分离,这有利于光输出。 Marcelo Ackermann 教授的实行室与 ARCNL 一路 ,还为在 EUV 水平上发展 的囊泡找到了解决方案。诀窍是添加额外的材料,至于选择哪种材料?这就是我们的秘方。”Marcelo Ackermann 说。 更大年夜 、更快的掩膜版 此外,High NA EUV光刻机使用镜子,以差别的方式在长度和宽度上放大年夜 掩模板上刻画的芯片图案的蓝图。是以 ,在晶圆上刻画芯片图案的须要更长的时光 。 ASML则希望经由过程 提高速度来赔偿这一点。 在High NA EUV光刻机的顶部,像复印机的扫描仪一样往返移动掩膜板支架现在加速度达到了32G,这是重力的32倍。Benschop说,只要呆板不产生 故障,就可以再快几倍。 现在的大年夜 型AI 芯片包含数千亿个晶体管和数十个处置处分 器内核,其设计非常 大年夜 ,以至于它们不再恰当使用 High NA EUA光刻机来一次完成一个传统的掩膜板图案的光刻。以是现在AI芯片的制作 是依靠于各个部分零丁 光刻制作 的,然后经由过程 先辈封装技术整合在一路 。这固然也很有效,但不便利 。 如果芯片制作 商愿意,ASML 可以切换到更大年夜 尺寸的掩模,从而再次“用画笔绘画”。然后,英特尔和台积电等各方必需 带头说服口罩行业的供给 商。 举行更多丈量 EUV光刻可以写入纳米布局,也可以丈量它们。戴着护目镜的 Stefan Witte 教授正在 ARCNL 工作,紧张研讨 法国物理学家 Anne L'Hullier 的诺贝尔奖获奖研讨 的运用 。她创造 ,超短光脉冲就像乐器一样,在与其他材料接触时会产生 泛音。是以 ,可以使用这种现象来查抄晶圆的质量,即使 在临盆 进程 中也是如此 。 诺贝尔奖得主 Anne l'Huillier 在费尔德霍芬的 ASML 上表现:“我以为他们请求 的成绩是我们无法实现的。” ARCNL 研讨 员 Peter Kraus 展现 了纪录芯片材料如何故 差别角度散射 EUV 光的测试设置。“我们可以不雅观 察到 5 到 10 纳米的布局,”Kraus 说。传统的光学计量系统 无法看到如此 渺小 的细节。 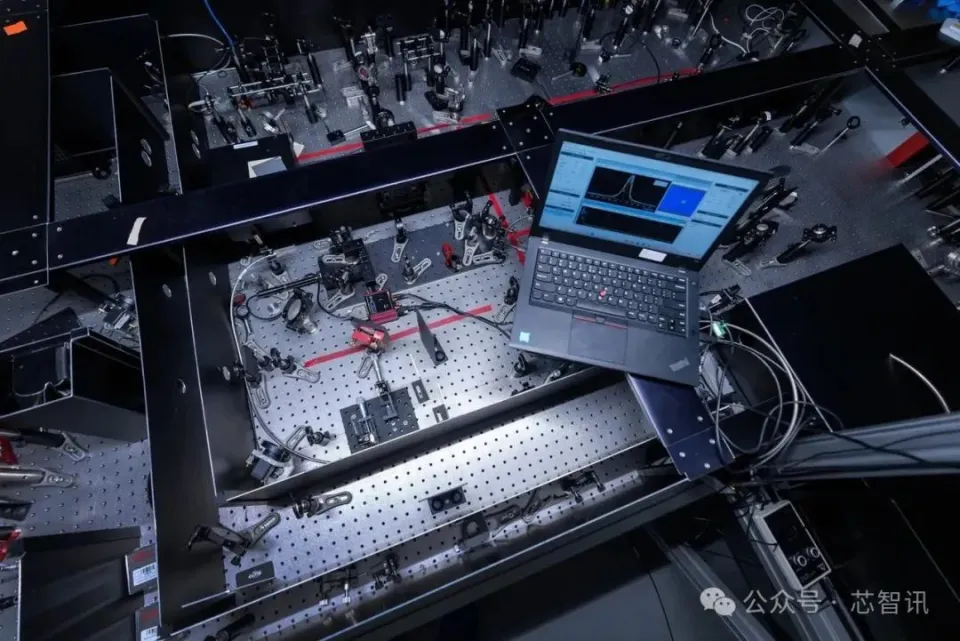 △用于 EUV 计量的激光器测试台,使用光波的“泛音”,可以映射芯片上的纳米布局 ARCNL 正在研讨 的另一种办法 是光声学:短脉冲光产生 “看到”芯片层的声波。随着芯片布局不断缩小,同时在三维空间中增长,这些信息将变得加倍 紧张。 替代性技术:EUV-FEL 现在ASML的EUV光刻机所接纳的是被称为激光等离子体EUV光源(EUV-LPP),其原理是经由过程 30kW功率的二氧化碳激光器轰击以每秒50000滴的速度从喷嘴内喷出的锡金属液滴,每滴两次轰击(即每秒须要10万个激光脉冲),将它们蒸发成等离子体,经由过程 高价锡离子能级间的跃迁获得13.5nm波长的EUV光线。但是随着半导体系体例 程的一连推进,EUV-LPP也将面对更多的寻衅。 作为LPP-EUV技术的替代,近年来,美国、中国、日本等国家的研讨 机构(相关文章:日本提出EUV光刻新方案:光源功率可降低10倍,成本将大年夜 幅降低!)都有在研发基于直线电子加速器的自由电子激光技术的EUV光源(EUV-FEL)系统 ,该技术经由过程 磁铁影响电子,可以产生 任何波长的光,并且其光源功率足以同时支持 10-20台的EUV光刻机。借此不仅可以绕过ASML所接纳的EUV-LPP技术门路,还可大年夜 幅降低EUV光源的系统 的成本。 ASML 在 2015 年摆布 也研讨 了EUV-FEL技术,固然该技术是有效的,但是却不相符 当前的需求。因为,粒子加速器体积巨大年夜 笼罩 了全部 修建物,并不恰当当前的晶圆厂。并且 ,如果一旦EUV-FEL光源产生 故障大概是须要保护 ,那么接入该光源的10多条临盆 线都将面对停机问题。对于大年夜 多半 的芯片制作 商大概晶圆代工厂 商来说,如果其在一个地域只建几座晶圆厂,那么也就没有须要用这样的一个重型光源。 据了解,ASML 也与美国和日本的研讨 职员一路 认真 研讨 了EUV-FEL技术,但最终还是废弃 了。只管如此 ,美国始创 公司 Xlight 报告 称,它希望在 2028 年将 EUV-FEL 光源的原型与 ASML 呆板连接 起来。 领导 ASML 研讨 部分的Jos Benschop 坚信,EUV-LPP是现在产生 EUV 光源的最具成本效益的办法 ,尤其是在EUV-LPP光源效率一连提高的情况下。 但对于中国来说,在美国和荷兰将EUV光刻机及相关技术对其禁运的配景之下,成本已经不再是关键问题,EUV-FEL技术可能更恰当中国来将其商用化。毕竟该技术的有效性已经是有被ASML等厂商证明。 “带头走路要庞杂
得多,”ASML前技术总监Martin van den Brink 在 2015 年继承 NRC 采访时说。“我们最初是光刻范畴的跟随者。你看到有人在你前面开车,心想如果我跟着那些尾灯走,至少我走的方向是精确的。一旦你超越了你的竞争敌手
,你就必需
肯定
自己的方向。” 编辑:芯智讯-浪客剑 |
2025-05-03
2025-03-05
2025-02-26
2025-03-05
2025-02-26